作为5G元年的2019已经过去,随着四大运营商的基础设施投资和建设的不断推进,2020年将正式迈入5G时代,很快我们将体验到前所未有的5G工作和生活场景。利用更高速率、更宽带宽、更高可靠性、更低时延的5G技术,给生产和生活带来翻天覆地的变化。
5G是一个万物互联的时代,机器与机器能够通信将成为普遍的特点。据赛迪智库《5G十大细分应用场景研究报告》,5G将在VR/AR、超高清视频、车联网、联网无人机、远程医疗、智慧电力、智能工厂、智能安防、个人AI设备、智慧园区等方面大放异彩,具有非常广阔的前景。对于这些应用场景来说,依赖于5G的基础设施以及支撑技术的云计算,边缘计算,AI等关键技术,搭配场景终端设备,可完成极其丰富的功能和体验。

网络图片
对于5G设备,比如5G智能手机、网络环节的片上系统(SoCs)、射频集成电路(RFIC)等,在有温度和功耗限制的环境下,需要具备强大的数据处理能力,其可靠性设计是必须重点考虑的一个方面,尤其需要从芯片、封装、系统多层次考虑其热可靠性以及结构可靠性。
本文将重点讨论电子产品结构可靠性设计方面的典型问题及其仿真解决思路。
1. 电子产品对结构可靠性的要求
据美国空军航空电子整体研究项目(US Air Force Avionics Integrity Program)发现,电子产品失效主要是由温度、振动、潮湿和粉尘引起。5G电子产品的性能和指标要求就更加苛刻,拿最典型的终端产品——手机来说,其5G功能工作在更高的频段,物理尺寸更加紧凑,电磁损耗更集中,其性能却更容易受到温度的影响,以及受到长时间外部使用环境的影响,因此,其具有更高的结构可靠性要求。

对于电子产品结构可靠性分析来说,可以从部件、系统两个维度进行分析;当然,电子产品可靠性也是一个复杂的多物理场分析过程。比如5G芯片设备,先进封装技术是保障5G芯片设备发挥极限性能,且低功耗要求的关键技术,高可靠性的封装就是5G芯片设备能长时间安全运行的保证。
时下先进的2.5D IC / 3D IC封装技术,包括通过硅通孔(TSV),管芯和晶片堆叠,系统封装(SiP),层叠封装(PoP),高级晶圆级封装(WLP),将成为5G芯片封装设计的主流选择。短互连路径由于提高了I / O速度,堆叠芯片之间的TSV实现更高的性能。它们还消耗较低的功率,因为堆叠了多个管芯,因此减小了电容并减小了尺寸。尽管这是一个非常有前途的技术,但由于其复杂性,仍充满了挑战。
系统层面,组装在一起的5G终端产品,还需考虑整机设备的变形、振动、跌落碰撞、散热等问题。而这些问题,都是典型的结构可靠性和热可靠性方面的问题。
2. PCB/封装的结构可靠性
如前所述,先进封装是5G芯片设备的关键技术,而日益增长的性能要求和严苛的使用环境,对先进封装的结构可靠性也提出了很大的挑战。典型的问题有如下几个方面,后面的分析也将在这几个方面展开。
-
PCB/封装在循环温度作用下的翘曲分层
-
PCB/封装在潮湿环境下吸湿膨胀(爆米花效应)
-
封装器件在振动冲击作用下失效等
-
封装焊球在温度循环下产生疲劳裂纹和失效
2. 1 PCB/封装在Flip Chip工艺+循环温度作用下的翘曲变形
在半导体行业,Flip Chip工艺广泛用于PCB/封装等器件连接,在此工艺下,封装就会有残余变形和应力的产生,也有塑性应变的存在。当PCB/封装连接后,还会对其进行相应的温度循环测试。使用Ansys Mechanical工具对整个流程进行仿真,可以了解Flip Chip工艺产生的塑性状态对后续温循仿真的影响。
对于PCB/封装仿真而言,想要得到准确仿真结果,PCB和封装的材料属性是关键。但对于PCB和封装的结构过于复杂,且特征尺寸小,如果按传统分网格的方法,网格量会巨大,操作起来也不现实;如果考虑计算效率,对每层PCB板赋予相同材料属性,那计算精度就会大打折扣。
那有没有一种既考虑精度又能兼顾效率的方法?
答案是肯定的!Ansys专利技术 “Trace Mapping” 正好可以解决PCB仿真的材料模型计算的难题。
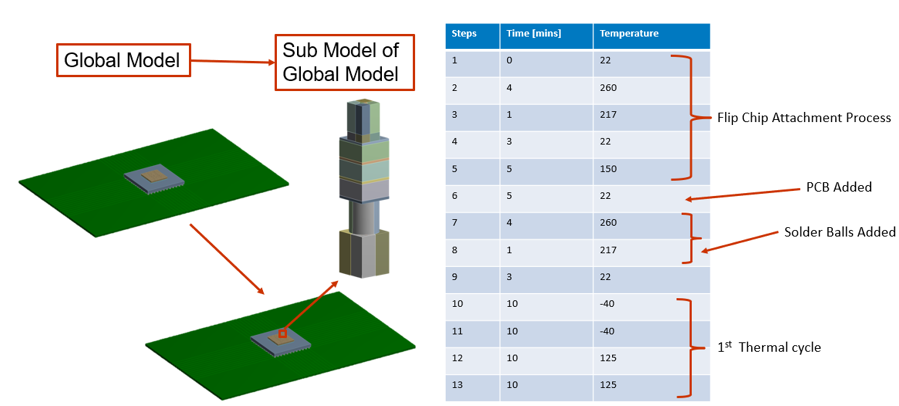
仿真模型和温度条件
通过SCDM导入EDA软件里建立的PCB板模型,考虑每一层每个位置的含铜率,计算每一层PCB每个位置的热物参数(各向异性),比如:密度、导热系数、热膨胀率、泊松比等。
然后通过trace import将计算的详细热物参数导入到Mechanical中,Map到多层矩形板上,Map后的矩形板虽然不具有原来PCB板的几何结构和特征,但是具有原来PCB板的详细热物参数。
因为进行热力计算时,影响热力仿真准确性的主要是PCB板自身的热物参数准确性,所以即使矩形板没有详细几何特征,也可以进行准确的热力计算。
使用Trace Mapping方法准确计算PCB各处的材料属性,再结合生死单元、子模型方法,就可以对Flip Chip+温循工艺进行多尺度精确分析,得到PCB/封装结构的受力和变形。

Layer7 Dielectric Metal

封装中金属和介质材料等效应力
2.2 PCB/封装在潮湿环境下吸湿膨胀(爆米花效应)
塑封是广泛应用的电子封装技术之一。其封装的基板和塑封料主要成分是树脂,具有亲水性和多孔性。当水分进入封装中,会使得塑封的电子元器件发生由于吸湿引起的界面层破裂和电子元器件的整体失效破坏,甚至发生“爆米花”式的断裂[1]。所以如美国空军航空电子完整性项目发现的,湿度也是引起电子产品失效的重要因素。
对吸湿分析而言,最主要是依据湿度的扩散机理,获取封装中湿度分布,最后分析湿度应力。在Ansys中采用菲克第二定律(Fick’s second law)来预测随着时间变化,扩散对浓度分布的影响:

同时为了求解湿度应力,需要热-结构-扩散直接耦合单元22X系列求解计算(该方法已开发成ACT集成在workbench中)。通过以上湿度扩散和耦合单元,可以获得封装结构湿度分布和湿应力状态,用于找出封装结构薄弱区域。参考GB2423.3-93等行业标准,可以对封装在湿度环境下进行试验,采用Ansys解决方案可以再现该湿度测试试验。
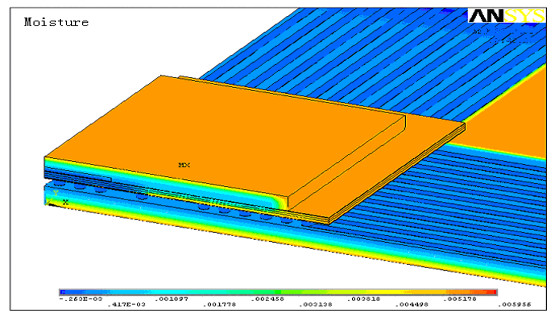
封装中湿度浓度分布
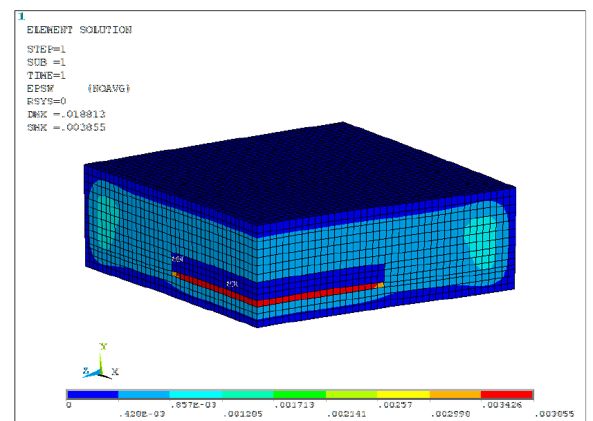
封装中湿应力引起的应变
2.3 PCB/封装器件在振动冲击作用下失效
在某些情况下,振动冲击所引起的部件失效也会成为封装结构主要的失效原因,同时封装结构在受到冲击的同时,也会受到热应力的影响。如何同时评估热应力和振动的影响,得到封装结构的损伤,最终得到封装使用寿命是一个需要重点考虑的方向。
对于振动分析,材料属性也非常关键。类似于温度循环分析,同样可以采用Ansys “Trace Mapping”来等效计算封装的材料属性,对于封装结构在有热应力作用下分析,可以在Ansys Workbench采用以下流程进行计算:

考虑热应力的振动仿真流程
对于PCB/封装的热分析,可以采用Ansys Mechanical中的热模块计算,得到PCB/封装结构的温度分布。温度分布结果可以无缝传递到结构分析模块,计算得到温度所引起的热应力分布。预应力结果同样可以无缝传递到模态分析中,改变结构的刚度,从而改变PCB/封装的整体振动特性。
通过以上流程,我们可以尽量考虑温度对振动特性的影响。如果要分析随机振动疲劳,在该流程中也能实现:
随机振动疲劳仿真
在随机振动后处理中,插入疲劳模块,就可以进行随机振动计算。默认使用电子行业主流的Steinberg随机振动疲劳模型。这样就可以在统一平台下,完成带预应力(热应力)下,随机振动分析及振动疲劳分析。
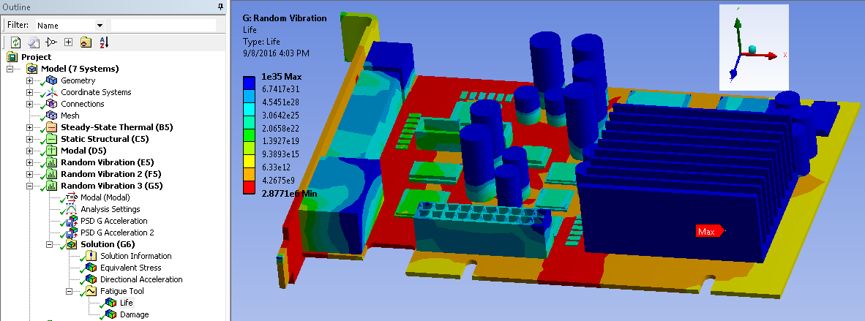
随机振动疲劳寿命分布
2.4 封装焊球在温度循环下产生疲劳裂纹和失效
电子封装中广泛采用SMT封装技术及新型的芯片尺寸封装(CSP)、球阵列(BGA)等封装技术均要求通过焊点直接实现电气及刚性结构连接。焊球和非金属材料的热膨胀系数差异巨大,工作在高温下会引起热应力,造成焊球的热应变。同时电子器件频繁开关,让焊点在高低温下经受往复应力作用。因此焊球容易在高低温循环下产生裂纹及扩展[2]。因此焊球的可靠性将在很大程度上决定系统的可靠性。
Ansys 采用电子封装行业主流的Anand粘塑性模型表征焊球材料特性,Darveaux模型来进行焊球寿命预测,并且在Ansys APP Store里有对应ACT插件,操作简单。此外,对应PCB板仍可使用 “Trace Mapping” 来等效计算PCB的材料属性,提高仿真精度和效率。如下图,使用该焊球疲劳预测插件,可以快速计算出焊球在完全断裂前的温循次数(焊球寿命)。
经过温循计算后,可以看到封装结构的变形(放大60倍效果)

温循变形
当然,经过Ansys Solder Fatigue 插件计算后,可以快速计算出,焊球在温循下的寿命.

Solder Fatigue插件中需要输入的参数

最终计算得到的焊球温循寿命
3. 终端设备的结构可靠性
对于5G终端系统而言,单个模块可靠性合格并不代表终端系统结构可靠性合格。组装在一起的5G终端产品,更多的会考虑整机设备的变形、振动、跌落碰撞、散热等问题。对于终端设备,例如手机,会依照相应的行业标准进行试验测试。
接下来,就介绍下相关试验测试在Ansys仿真环境中的实现。
3.1 弯曲试验

网络图片
5G手机在往越来越薄的趋势发展,这时候弯曲刚度也会随之减小。依据IEC 61189-2:TM20,ASTM D790等行业标准,对智能手机进行相应的三点弯曲试验,来评估手机抗弯曲性能。依据标准在Ansys Mechanical中可以建立以下的分析模型:
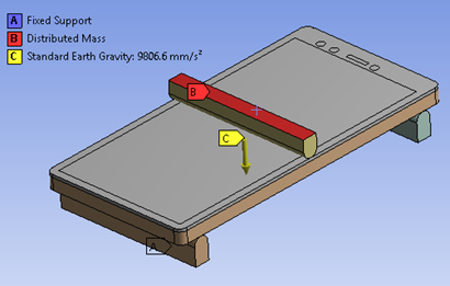
使用Ansys 仿真环境可以再现三点弯曲的过程,分析得到弯曲后手机的变形,预测手机器件的弯曲刚度,确定关键部件在高应力水平下是否破坏及疲劳寿命。
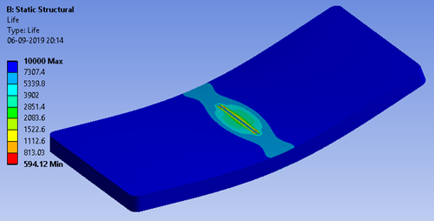
3.2 扭转试验
智能手机在使用中也会碰到类似扭曲的情况,而越来越薄的手机的扭转刚度也相应降低了。依据IPC TM-650等行业标准可以对智能手机进行扭转测试,来评估手机抗扭曲性能。依据标准在Ansys Mechanical中可以建立以下的分析模型:
手机一端固定,另外一端施加5 °的旋转载荷。使用Ansys 仿真环境可以再现扭转的过程,分析得到扭曲后手机的变形,预测手机器件的扭转刚度,确定关键部件在高应力水平下是否破坏及疲劳寿命。
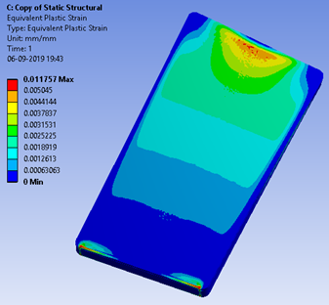
3.3 跌落测试
手机跌落碰撞应该是手机使用过程中最常出现的情况,会造成屏幕破损,关键部件破坏等。依据GB/T2423.8-1995,MIL-STD-810G测试标准,手机制造商可以进行相应的试验测试,但这是非常耗时和耗钱的,利用Ansys LS-DYNA建立虚拟的手机跌落测试平台,例如进行4角跌落,棱边跌落,平面跌落以及多次跌落等,可以在设计早期对手机结构进行优化,增强手机的抗跌落碰撞性能。
网络图片
而在Ansys 环境下,还有相应的跌落测试模板,帮助客户快速建立手机跌落有限元模型。依靠显式动力学鼻祖LS-DYNA求解器和Ansys workbench优化平台,可以对手机跌落进行准确仿真,探索手机薄弱部位;同时借助Ansys 参数优化工具DX对手机结构进行优化,增强手机的抗跌落碰撞性能。
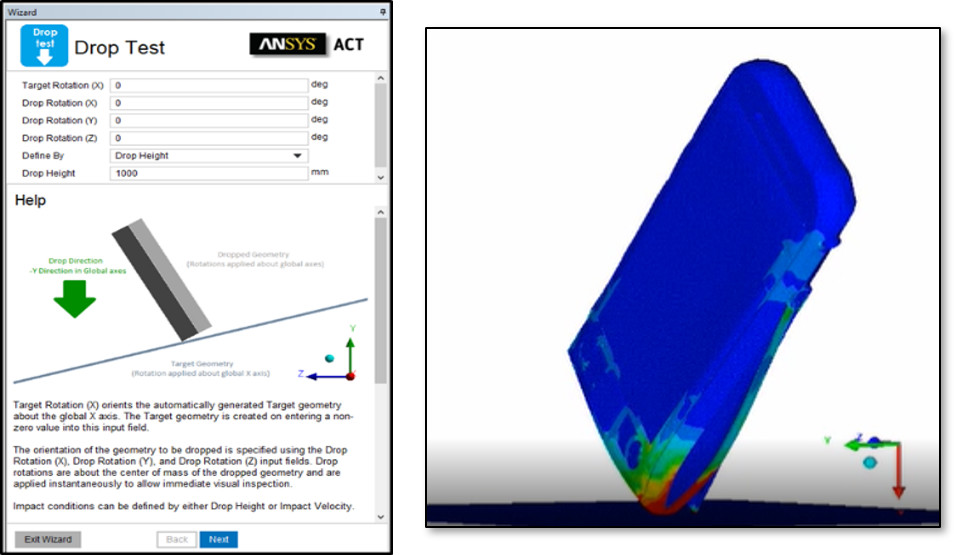
电子产品的可靠性关系到安全性、适用性和耐久性,引起电子产品可靠性失效的因素也有很多,如何预测并优化电子产品可靠性一直就是业界的一大难题。Ansys在统一平台下从芯片、PCB/封装等部件级到5G终端设备的系统级别都可以提供相应的可靠性方案,精度高效率快,可以再现电子产品失效的整个历程,得到失效结果,帮助工程师们改进优化电子产品的结构可靠性。
|